4月17日,A股玻璃基板概念板块延续强势表现。帝尔激光收获20cm涨停,沃格光电、彩虹股份双双封板,凯格精机、德龙激光盘中创出阶段新高。市场资金对这一细分赛道的高度关注,直接导火索指向全球半导体巨头台积电最新释放的技术路线信号——该公司正在搭建CoPoS封装技术的试点产线,长远目标是用玻璃基板取代传统的硅中介层。
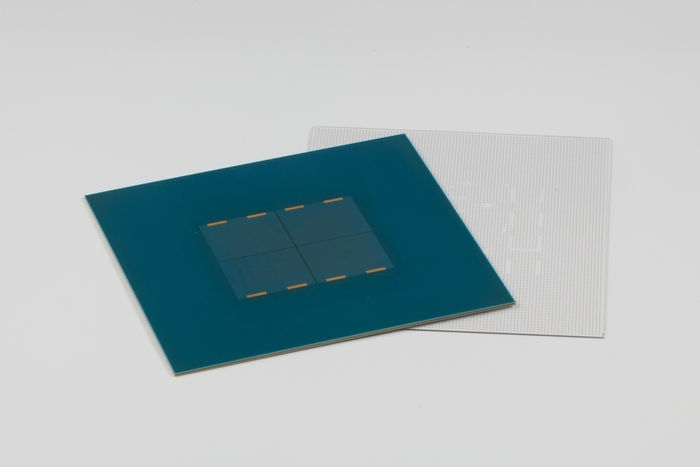
这不仅是封装材料的简单替换。在AI算力需求持续井喷、芯片复杂度指数级攀升的背景下,从有机基板到玻璃基板的跃迁,正成为延续摩尔定律、突破性能瓶颈的关键一战。
台积电释放明确信号:CoPoS试点产线加速落地
4月16日,台积电发布了一份超出市场预期的亮眼财报。更引人关注的是,公司董事长兼总裁魏哲家在财报会议上同步透露,台积电正在搭建CoPoS封装技术的试点产线,预计几年后可进入量产阶段。
魏哲家指出,目前台积电先进封装产能已是业内规模最大,但供应仍持续吃紧。公司在扩充自身产能的同时,也在持续与后段专业封测代工厂商(OSAT)密切合作。
据媒体此前报道,台积电的CoPoS中试生产线已于今年2月开始向研发团队交付设备,预计将于6月全面建成整条生产线。这一进度远超市场预期,显示出台积电对玻璃基板技术路线的重视程度。
产业人士分析认为,台积电延伸CoWoS技术路线至CoPoS,核心驱动力来自两方面:一是面板化是克服先进封装产能瓶颈的有效方案,随着AI芯片光罩尺寸持续放大,方形面板可大幅提升利用率与产出效率;二是玻璃基板取代硅中介层,能够有效降低成本、提升产能效率,以满足AI芯片客户庞大的需求。
为何是玻璃?传统有机基板已逼近物理极限
AI算力激增带来的散热与封装挑战,正在将传统有机基板推向物理极限。高温下的翘曲变形,已成为制约芯片性能提升的关键瓶颈。产业人士指出,面对英伟达Rubin GPU等大尺寸AI芯片,12吋晶圆仅能封装7颗甚至4颗,效率明显受限。
玻璃基板正是在这一背景下走上前台。其核心竞争优势源于与传统材料相比的显著性能差异:
从材料特性来看,玻璃基板的热膨胀系数可精准调控至3-5ppm/℃,与硅芯片高度匹配。高温下翘曲量较有机基板减少70%以上,彻底解决了AI芯片封装的核心机械失效难题。其表面粗糙度控制在1纳米以下,比有机材料光滑5000倍,可支持0.5微米级线宽/间距的精细布线,互连密度可达传统有机基板的10倍以上。
在性能层面,玻璃基板的介电常数约3.7,介电损耗较有机基板降低50%以上。英伟达实测数据显示,采用玻璃基板的芯片信号传输速率提升3.5倍,带宽密度提高3倍,功耗降低50%,精准匹配AI芯片、高速通信芯片的高频传输需求。
更重要的是,玻璃基板可直接集成光引擎,为CPO(共封装光学)技术提供核心支撑,助力数据中心突破功耗与带宽瓶颈。1.6T/3.2T光互联技术的落地,进一步放大了玻璃基板的市场价值。
巨头竞速:英特尔率先量产,三星全链布局,台积电聚焦工艺
面对这一确定性方向,全球半导体巨头已展开激烈竞逐,各自的技术路线和量产节奏正逐步清晰。
英特尔是这场竞赛中的先行者。公司在亚利桑那州累计投入超10亿美元建设玻璃基板专属研发与量产线。今年1月,英特尔正式宣布玻璃基板技术进入大规模量产阶段。其首款搭载玻璃核心基板的Xeon 6+“Clearwater Forest”服务器处理器,成为业界首个实现商业化落地的玻璃基板产品。英特尔数据显示,玻璃基板有望支撑单个封装实现1万亿晶体管集成,为延续摩尔定律提供核心支撑。
三星则通过全链条协同构建技术壁垒。三星电机自去年起持续向苹果提供玻璃基板样品,用于其代号为“Baltra”的自研AI服务器芯片测试。三星电机在韩国世宗工厂运营试产线,已实现TGV深宽比10:1、铜填充空洞率低于0.5%的工艺突破。同时,三星电机与日本住友化学合资成立公司,计划2026年下半年量产玻璃芯材料,目标2027年实现大尺寸基板的规模化量产。SKC旗下子公司Absolics也已向AMD等客户提供量产级样品。
台积电则聚焦面板级封装工艺创新,与康宁合作推进FOPLP(面板级扇出型封装)与玻璃基板的融合。双方联合制定行业标准,将CTE公差压缩至±0.5ppm/℃,介电常数离散度控制在2%以内,为规模化应用扫清技术标准障碍。
国内产业链多点突破
在海外巨头加速布局的同时,国内产业链也形成了“材料-工艺-设备”协同发展的格局。
彩虹股份在2026年4月的337调查中初裁获胜,认定其自主研发的“616”新料方玻璃基板不侵犯美国康宁公司专利,为国产材料进入全球市场扫清了合规障碍。
沃格光电掌握全球少数的TGV全制程工艺,武汉基地年产10万平方米TGV产线已实现量产,成都8.6代线正筹备2026年量产,产品已切入光模块封装供应链。
帝尔激光作为国内唯一量产TGV激光微孔设备的厂商,已完成面板级设备出货,为行业规模化加工提供核心装备支撑。公司在TGV激光微孔领域实现晶圆级和面板级封装激光技术全覆盖。
此外,长电科技4月17日宣布,成功完成基于玻璃通孔(TGV)结构与光敏聚酰亚胺(PSPI)再布线工艺的晶圆级射频集成无源器件(IPD)工艺验证,为5G及面向6G的射频前端与系统级封装优化提供了新路径。
天承科技则在玻璃基板通孔TGV金属化领域提供创新解决方案,在深宽比10至15的TGV填孔电镀加工效率和良率等关键指标上超越某国际品牌。
市场空间广阔,商业化元年开启
从市场规模来看,Yole Group预测,2025至2030年半导体玻璃晶圆需求将增长近三倍,2030年全球半导体玻璃基板市场规模有望突破80亿美元。应用场景上,玻璃基板将率先在AI服务器、HBM4存储封装、高性能计算等高端领域实现商业化,后续逐步向汽车电子、可穿戴设备等领域渗透。
据统计,A股市场已有数十只玻璃基板概念股。其中,沃格光电、天和防务、凯盛新能等个股机构一致预测今明两年净利增速均超100%;麦格米特、德龙激光、美迪凯等机构一致预测增速均超50%。
从材料替代到工艺重构,从设备升级到生态重塑,玻璃基板正以其独特的性能优势,撬动一个万亿级封装市场的深刻变革。随着台积电、英特尔、三星等巨头的量产节奏加速,2026年有望被市场定义为“玻璃基板商业化元年”。而在这场变革中,具备核心技术壁垒、率先实现量产突破的公司,将有望率先分享这一新兴市场的增长红利。