在AI时代,面对封装产品小型化、集成度和可靠性要求的提高,如何在不牺牲性能的前提下有效解决散热问题,已成为业界亟需解决的紧迫任务。在这样的背景下,封装方案开发阶段进行热仿真分析重要性日益凸显。
作为国内封装企业龙头之一,华天科技2011年率先成立仿真团队,建立了电、热、力、模流以及多物理场协同仿真能力。应对封装散热挑战,华天科技提供了一系列的热仿真解决方案,以确保在高性能AI芯片的设计和封装过程中,能够有效地管理和优化散热,从而为芯片封装提供基于可靠性、性能、成本的最优热设计方案。
热仿真分析主要对封装体内部温度分布进行分析,提供全面、准确的热性能参数和温度分布、散热瓶颈等信息。例如热阻参数、热流矢量图、电-热耦合仿真、系统级散热方案分析、封装温度分布云图、散热器选择等,并进行不同封装设计方案的热性能比对,提供散热优化方向。

封装结构散热性能分析:通过对比不同封装形式散热能力,推荐最佳散热方案。以封装尺寸17*17mm为例,FC-CSP封装相较于WB-BGA封装在Theta-Ja、Theta-Jb及Theta-Jc分别实现了5%、8%和85%的散热改善;而HFC-BGA封装相较于WB-BGA封装在Theta-Ja、Theta-Jb及Theta-Jc分别实现了35%、70%和83%的散热改善。综合对比分析,WB-BGA、FC-CSP、OMFC-CSP及HFC-BGA不同的封装结构呈现的散热效果也不同,HFC-BGA封装热阻较低,若封装产品对热性能有较高要求,可优先考虑HFC-BGA封装形式。此外,针对基板类封装产品中基板的结构、材质进行专题研究,分析基板层数、介质层厚度、SMT散热孔及塑封厚度对封装产品散热的影响,在封装设计时可针对性进行优化,保证器件的正常稳定工作。
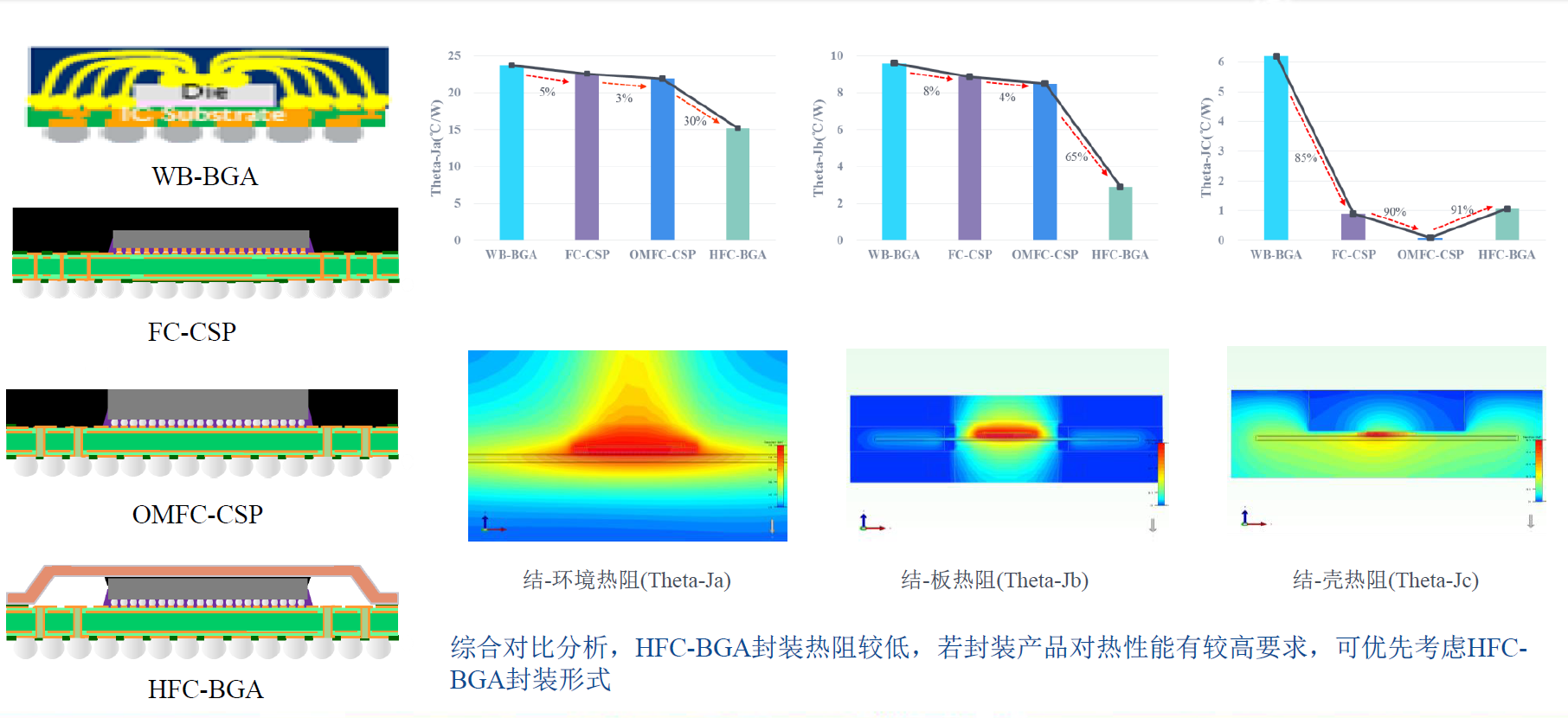

封装材料散热性能分析:对比不同型号塑封料及粘片胶对封装散热性能的影响,快速实现封装产品BOM选择,通过分析对比不同封装形式的材料散热性能,为各类封装产品量身定制热设计方案,满足特定的散热需求,根据产品的具体应用场景,推荐最合适的封装方案。
在大尺寸封装产品中,铟片凭借卓越的高导热性能被视为传统热界面材料TIM胶的替代品。HFC-BGA50X50 封装,基于JEDEC标准测试环境,采用铟片较采用TIM胶,Still Air环境,结温降低约6.3℃,Theta-Jc降低81.6%。与TIM胶相比,铟片产品在热量传递过程中的热阻更低,采用铟片散热效果更优于TIM胶。
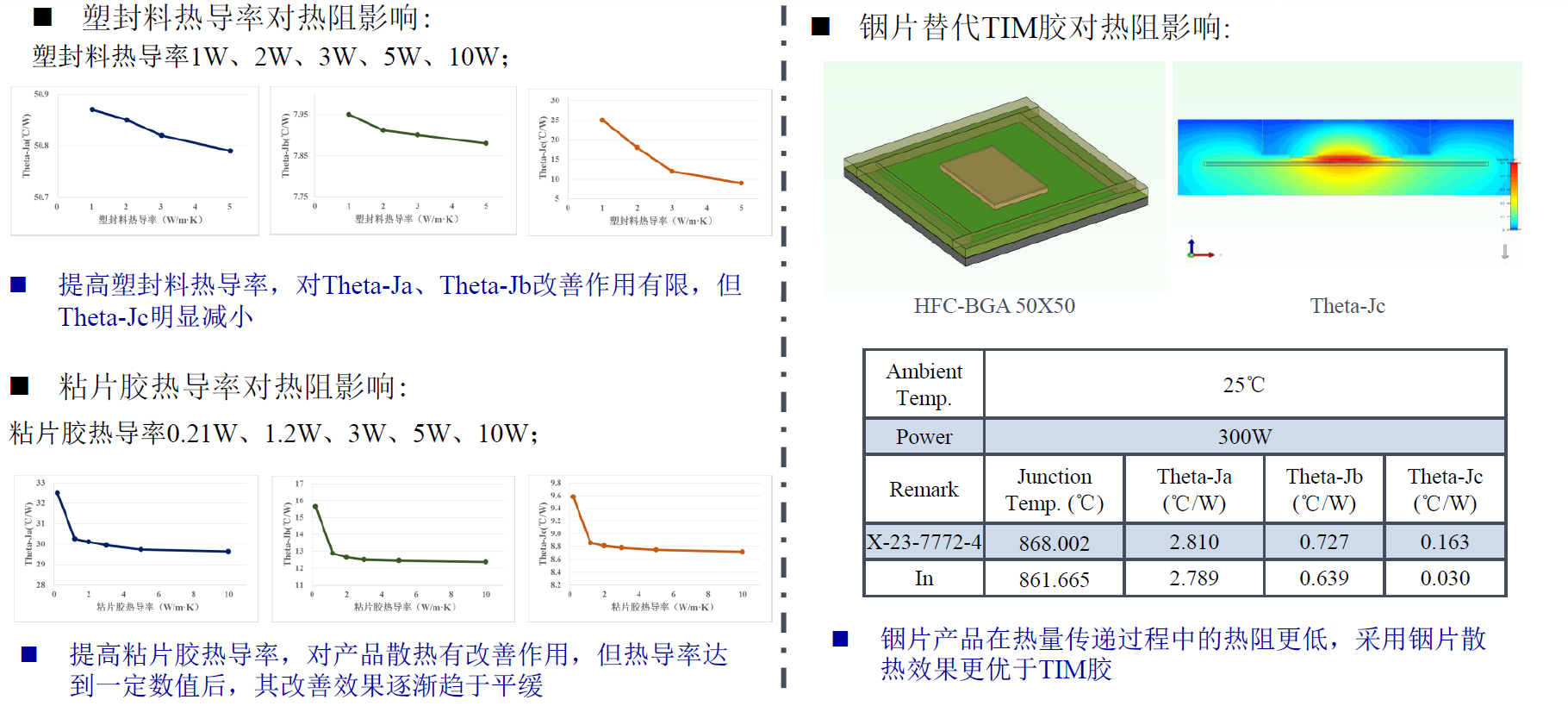
热仿真团队通过仿真数据与实际产品的测试数据进行校正,累计十余年2000多款产品开发经验和大量课题研究,建立了全面准确的仿真数据库。热仿真数据库建立,实现了快速评估封装产品的散热性能,有效降低产品在早期热设计阶段的风险,为客户更高效的提供热解决方案。通过这些数据的积累分析,华天科技能够确保其在产品封装系统的热设计上达到行业领先水平。
随着芯片算力的不断提升,华天科技将在包括散热仿真在内的多物理域协同仿真分析的加持下,通过提供精确的热仿真和高效的设计优化功能,为客户提供更高质量的封装解决方案,满足AI时代对高性能计算的散热需求。









