近期,OpenClaw开源AI智能体框架引发的“养龙虾”现象席卷全网,标志着AI从对话式交互迈入自主智能体时代。这一转变对底层芯片提出更高算力、更大带宽与更优能效比的严苛要求。在后摩尔时代,制程微缩趋缓,先进封装已成为突破AI芯片性能瓶颈的关键路径。其中,板级封装(Panel Level Packaging)凭借面板级扇出工艺,具备优异的设备、材料利用率和产出效率,正将封装效率与系统性能的挑战转化为核心优势。
3月25日,SEMICON China 2026在上海新国际博览中心盛大开幕。奕成科技携板级高密系统封测解决方案亮相,全面展示了FOPLP(板级扇出型封装)如何以更大尺寸、更高效率的高密互联,助力AI芯片异构集成与性能提升。

AI+时代,先进封装乘势而上
当前先进封装的发展趋势:
2.5D/ 3D等封装技术为AI、数据中心等场景提供算力提升支撑
FOPLP(板级扇出型封装)、CPO(光电共封装)等创新技术加快工艺稳定验证
FOPLP凭借更高的面积利用率、产出率,更低单位成本,成为支持高性能芯片规模量产的关键路径
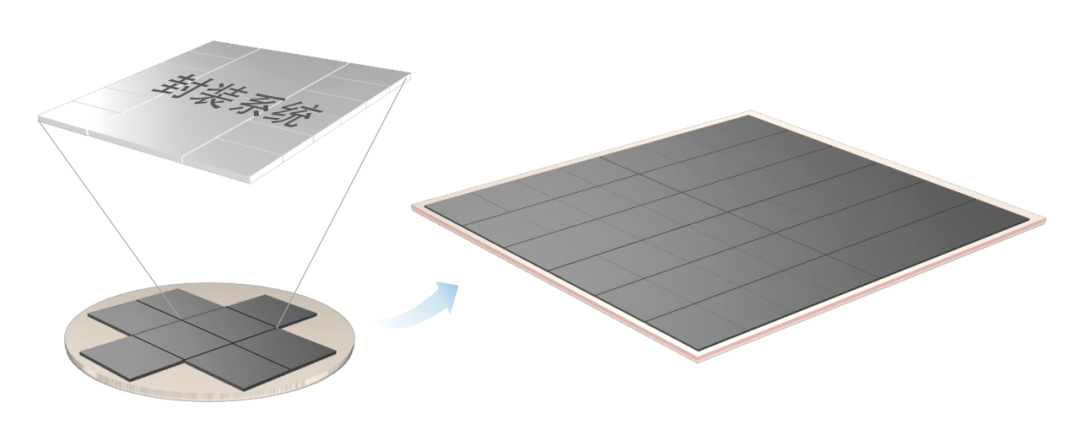
FOWLP/ FOPLP对比图
EHIoP® 板级高密技术平台:
聚焦AI算力与异构集成关键应用
本次大会,奕成科技重点展示EHIoP® 板级高密技术平台,包括2D FO、2.xD FO、FOPoP、FC、Advanced SBT等多种先进封装技术,面向AI+时代,提供从小芯片/ 模组到高性能异构集成的系统解决方案,覆盖多元化应用场景。
EHIoP® 平台核心代表产品:
2D FO
Die first
芯片5面 /6面包覆
无封装基板(Substrate-less)
可进行单芯片、多芯片系统集成
应用于移动与消费电子、汽车与工业等广泛领域
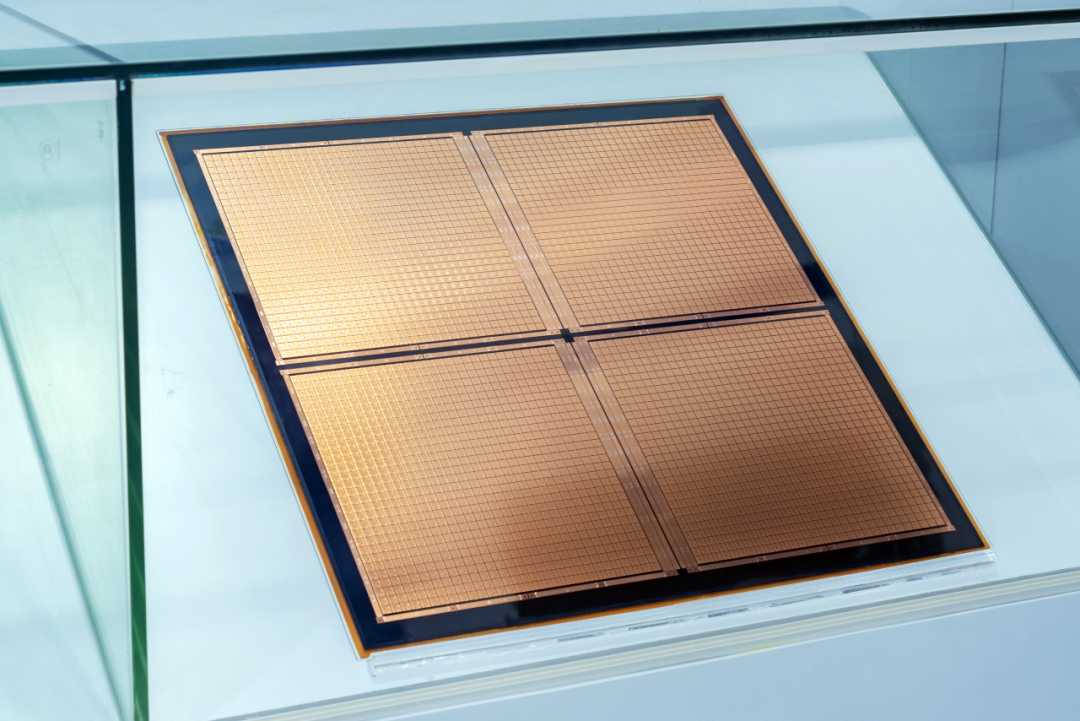
奕成科技2D FO封装产品
2.xD FO
RDL first,L/S : 2/2 μm,高密度互连
FO Size : 50*70mm
Substrate Size : 90*115mm
w/o or w. Si Bridge,优异的成本竞争力
灵活、高性能同构 /异构集成
应用于AI、ASIC、CPU等高性能计算场景

奕成科技2.xD FO封装产品

此外,奕成科技拥有大陆唯一板级高密系统封测工厂,2024年率先实现板级高密FOMCM平台批量量产,2025年完成多款产品百万颗级出货,成功实现从技术验证到规模量产的跨越。
未来,奕成科技将持续锚定高端应用赛道,加码技术研发与规模量产落地,为客户提供从封装设计到最终测试的系统封测解决方案,助力AI算力生态建设与板级封装产业链高质量发展。










